სილიციუმის კარბიდის შესავალი
სილიციუმის კარბიდი (SiC) ნახშირბადისა და სილიციუმისგან შემდგარი ნახევარგამტარული ნაერთი მასალაა, რომელიც ერთ-ერთი იდეალური მასალაა მაღალი ტემპერატურის, მაღალი სიხშირის, მაღალი სიმძლავრის და მაღალი ძაბვის მოწყობილობების დასამზადებლად. ტრადიციულ სილიციუმის მასალასთან (Si) შედარებით, სილიციუმის კარბიდის ზოლური უფსკრული 3-ჯერ მეტია სილიციუმის ზოლზე. თბოგამტარობა 4-5-ჯერ მეტია სილიციუმის ზოლზე; დაშლის ძაბვა 8-10-ჯერ მეტია სილიციუმის ზოლზე; ელექტრონული გაჯერების დრიფტის სიჩქარე 2-3-ჯერ მეტია სილიციუმის ზოლზე, რაც აკმაყოფილებს თანამედროვე ინდუსტრიის მოთხოვნილებებს მაღალი სიმძლავრის, მაღალი ძაბვის და მაღალი სიხშირის კუთხით. იგი ძირითადად გამოიყენება მაღალსიჩქარიანი, მაღალი სიხშირის, მაღალი სიმძლავრის და სინათლის გამოსხივების ელექტრონული კომპონენტების წარმოებისთვის. შემდგომი გამოყენების სფეროები მოიცავს ჭკვიან ქსელს, ახალი ენერგიის სატრანსპორტო საშუალებებს, ფოტოელექტრულ ქარის ენერგიას, 5G კომუნიკაციას და ა.შ. სილიციუმის კარბიდის დიოდები და MOSFET-ები კომერციულად გამოიყენება.

მაღალი ტემპერატურისადმი მდგრადობა. სილიციუმის კარბიდის ზოლის სიგანე 2-3-ჯერ აღემატება სილიციუმისას, ელექტრონები ადვილად არ გადადიან მაღალ ტემპერატურაზე და უძლებენ უფრო მაღალ სამუშაო ტემპერატურას, ხოლო სილიციუმის კარბიდის თბოგამტარობა 4-5-ჯერ აღემატება სილიციუმისას, რაც მოწყობილობის სითბოს გაფრქვევას აადვილებს და სამუშაო ტემპერატურის ზღვრულ მაჩვენებელს ზრდის. მაღალი ტემპერატურისადმი მდგრადობამ შეიძლება მნიშვნელოვნად გაზარდოს სიმძლავრის სიმკვრივე და ამავდროულად შეამციროს გაგრილების სისტემის მოთხოვნები, რაც ტერმინალს უფრო მსუბუქს და პატარას ხდის.
მაღალი წნევისადმი გამძლეობა. სილიციუმის კარბიდის ელექტრული ველის დაშლის სიძლიერე 10-ჯერ აღემატება სილიციუმისას, რომელსაც შეუძლია მაღალი ძაბვისადმი გამძლეობა და უფრო შესაფერისია მაღალი ძაბვის მოწყობილობებისთვის.
მაღალი სიხშირის წინააღმდეგობა. სილიციუმის კარბიდს აქვს სილიციუმთან შედარებით ორჯერ მეტი გაჯერებული ელექტრონების დრეიფის სიჩქარე, რაც იწვევს გამორთვის პროცესში დენის შეფერხების არარსებობას, რამაც შეიძლება ეფექტურად გააუმჯობესოს მოწყობილობის გადართვის სიხშირე და მინიატურიზაცია მოახდინოს.
დაბალი ენერგიის დანაკარგი. სილიკონის მასალასთან შედარებით, სილიციუმის კარბიდს აქვს ძალიან დაბალი ჩართვის წინაღობა და დაბალი დანაკარგი. ამავდროულად, სილიციუმის კარბიდის მაღალი ზოლური უფსკრული მნიშვნელოვნად ამცირებს გაჟონვის დენს და სიმძლავრის დანაკარგს. გარდა ამისა, სილიციუმის კარბიდის მოწყობილობას გამორთვის პროცესში არ აწუხებს დენის ჩამორჩენის ფენომენი და გადართვის დანაკარგი დაბალია.
სილიკონის კარბიდის ინდუსტრიული ქსელი
ის ძირითადად მოიცავს სუბსტრატს, ეპიტაქსიას, მოწყობილობის დიზაინს, წარმოებას, დალუქვას და ა.შ. სილიციუმის კარბიდი მასალიდან ნახევარგამტარული ენერგეტიკული მოწყობილობისთვის განიცდის მონოკრისტალის ზრდას, ზოდის დაჭრას, ეპიტაქსიალურ ზრდას, ვაფლის დიზაინს, წარმოებას, შეფუთვას და სხვა პროცესებს. სილიციუმის კარბიდის ფხვნილის სინთეზის შემდეგ, ჯერ მზადდება სილიციუმის კარბიდის ზოდი, შემდეგ კი სილიციუმის კარბიდის სუბსტრატი მიიღება დაჭრით, დაფქვით და გაპრიალებით, ხოლო ეპიტაქსიური ფურცელი მიიღება ეპიტაქსიური ზრდით. ეპიტაქსიური ვაფლი მზადდება სილიციუმის კარბიდისგან ლითოგრაფიის, გრავირების, იონური იმპლანტაციის, ლითონის პასივაციის და სხვა პროცესების მეშვეობით, ვაფლი იჭრება შტამპად, მოწყობილობა იფუთება და მოწყობილობა გაერთიანებულია სპეციალურ გარსში და აწყობილია მოდულში.
ინდუსტრიული ჯაჭვის 1-ლი ზედა დინება: სუბსტრატი - კრისტალების ზრდა პროცესის ძირითადი რგოლია.
სილიციუმის კარბიდის სუბსტრატი სილიციუმის კარბიდის მოწყობილობების ღირებულების დაახლოებით 47%-ს შეადგენს, რაც წარმოების ყველაზე მაღალ ტექნიკურ ბარიერებს წარმოადგენს, ყველაზე დიდ ღირებულებას წარმოადგენს SiC-ის მომავალი მასშტაბური ინდუსტრიალიზაციის ბირთვს.
ელექტროქიმიური თვისებების განსხვავებების თვალსაზრისით, სილიციუმის კარბიდის სუბსტრატის მასალები შეიძლება დაიყოს გამტარ სუბსტრატებად (წინადადების არეალი 15~30 მმ·სმ) და ნახევრად იზოლირებულ სუბსტრატებად (წინადადების არეალი 105 მმ·სმ-ზე მეტი). ეს ორი სახის სუბსტრატი გამოიყენება დისკრეტული მოწყობილობების, როგორიცაა შესაბამისად დენის მოწყობილობები და რადიოსიხშირული მოწყობილობები, დასამზადებლად ეპიტაქსიური ზრდის შემდეგ. მათ შორის, ნახევრად იზოლირებული სილიციუმის კარბიდის სუბსტრატი ძირითადად გამოიყენება გალიუმის ნიტრიდის RF მოწყობილობების, ფოტოელექტრული მოწყობილობების და ა.შ. წარმოებაში. ნახევრად იზოლირებულ SIC სუბსტრატზე gan ეპიტაქსიური ფენის გაზრდით, მზადდება SIC ეპიტაქსიური ფირფიტა, რომლის შემდგომი მომზადება შესაძლებელია HEMT gan იზო-ნიტრიდის RF მოწყობილობებად. გამტარი სილიციუმის კარბიდის სუბსტრატი ძირითადად გამოიყენება დენის მოწყობილობების წარმოებაში. ტრადიციული სილიკონის ენერგომოწყობილობის წარმოების პროცესისგან განსხვავებით, სილიციუმის კარბიდის ენერგომოწყობილობის დამზადება პირდაპირ სილიციუმის კარბიდის სუბსტრატზე შეუძლებელია, სილიციუმის კარბიდის ეპიტაქსიური ფენა უნდა გაიზარდოს გამტარ სუბსტრატზე სილიციუმის კარბიდის ეპიტაქსიური ფურცლის მისაღებად, ხოლო ეპიტაქსიური ფენა იწარმოება შოტკის დიოდზე, MOSFET-ზე, IGBT-ზე და სხვა ენერგომოწყობილობებზე.
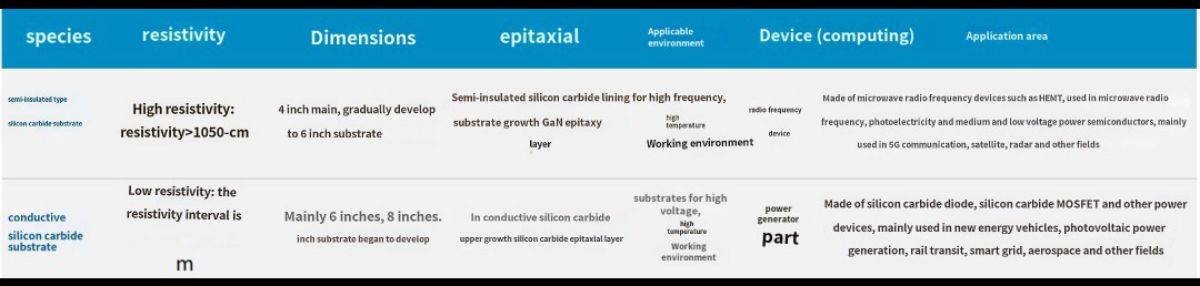
სილიციუმის კარბიდის ფხვნილი სინთეზირებული იქნა მაღალი სისუფთავის ნახშირბადის ფხვნილისა და მაღალი სისუფთავის სილიციუმის ფხვნილისგან, ხოლო სხვადასხვა ზომის სილიციუმის კარბიდის ზოდი გაიზარდა სპეციალური ტემპერატურული ველის პირობებში, შემდეგ კი სილიციუმის კარბიდის სუბსტრატი წარმოიქმნა მრავალი დამუშავების პროცესის მეშვეობით. ძირითადი პროცესი მოიცავს:
ნედლეულის სინთეზი: მაღალი სისუფთავის სილიციუმის ფხვნილი + ტონერი შერეულია ფორმულის მიხედვით და რეაქცია მიმდინარეობს რეაქციის კამერაში 2000°C-ზე მაღალი ტემპერატურის პირობებში, რათა სინთეზირდეს სილიციუმის კარბიდის ნაწილაკები კონკრეტული კრისტალის ტიპისა და ნაწილაკების ზომის მიხედვით. შემდეგ, დამსხვრევის, დაცლის, გაწმენდის და სხვა პროცესების მეშვეობით, მაღალი სისუფთავის სილიციუმის კარბიდის ფხვნილის ნედლეულის მოთხოვნების დასაკმაყოფილებლად.
კრისტალების ზრდა სილიციუმის კარბიდის სუბსტრატის წარმოების ძირითადი პროცესია, რომელიც განსაზღვრავს სილიციუმის კარბიდის სუბსტრატის ელექტრულ თვისებებს. ამჟამად, კრისტალების ზრდის ძირითადი მეთოდებია ფიზიკური ორთქლის გადაცემა (PVT), მაღალტემპერატურულ ქიმიურ ორთქლის დეპონირება (HT-CVD) და თხევადი ფაზის ეპიტაქსია (LPE). მათ შორის, PVT მეთოდი ამჟამად SiC სუბსტრატის კომერციული ზრდის ძირითადი მეთოდია, უმაღლესი ტექნიკური სიმწიფით და ყველაზე ფართოდ გამოიყენება ინჟინერიაში.

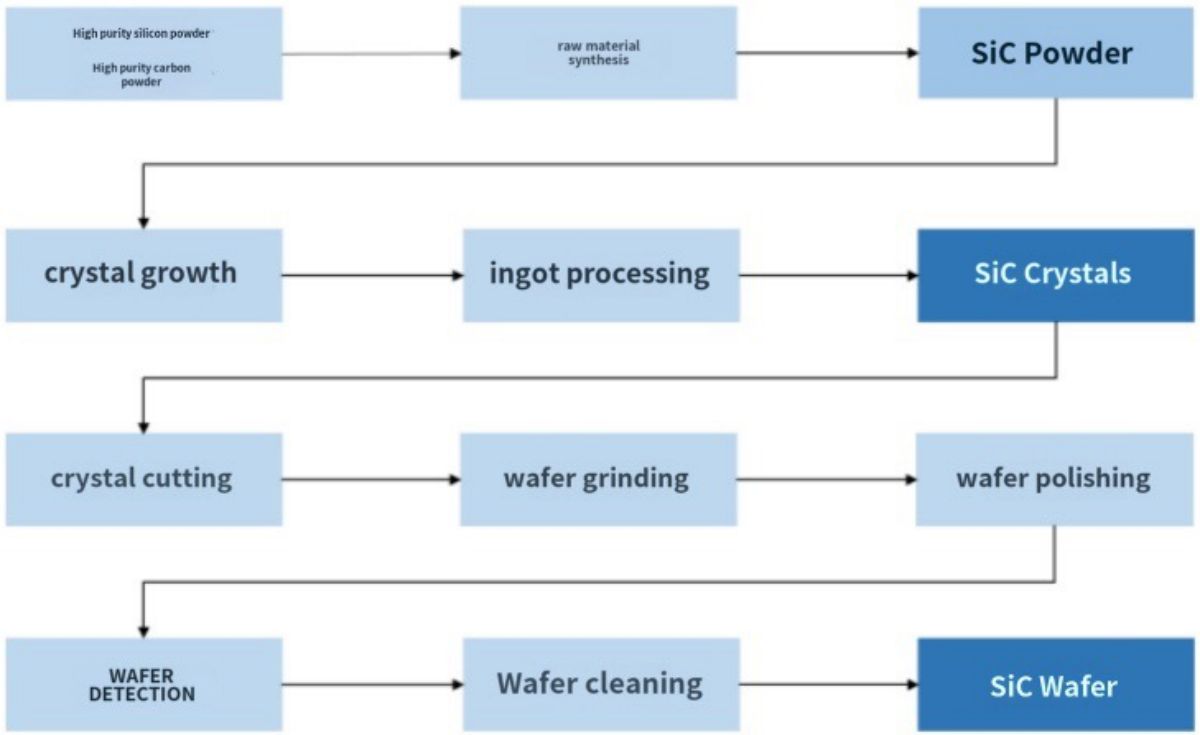
SiC სუბსტრატის მომზადება რთულია, რაც მის მაღალ ფასს განაპირობებს.
ტემპერატურული ველის კონტროლი რთულია: Si კრისტალური ღეროს ზრდას მხოლოდ 1500℃ სჭირდება, ხოლო SiC კრისტალური ღეროს გაზრდა 2000℃-ზე მაღალ ტემპერატურაზეა საჭირო და 250-ზე მეტი SiC იზომერია, მაგრამ ენერგეტიკული მოწყობილობების წარმოებისთვის მთავარი 4H-SiC მონოკრისტალური სტრუქტურა, თუ ზუსტი კონტროლი არ არის, სხვა კრისტალურ სტრუქტურებს მიიღებს. გარდა ამისა, ტიგანში ტემპერატურის გრადიენტი განსაზღვრავს SiC სუბლიმაციის გადაცემის სიჩქარეს და აირისებრი ატომების განლაგებასა და ზრდის რეჟიმს კრისტალის ინტერფეისზე, რაც გავლენას ახდენს კრისტალის ზრდის სიჩქარესა და კრისტალის ხარისხზე, ამიტომ აუცილებელია სისტემური ტემპერატურული ველის კონტროლის ტექნოლოგიის ჩამოყალიბება. Si მასალებთან შედარებით, SiC წარმოებაში განსხვავება ასევე მაღალი ტემპერატურის პროცესებშია, როგორიცაა მაღალი ტემპერატურის იონების იმპლანტაცია, მაღალი ტემპერატურის დაჟანგვა, მაღალი ტემპერატურის აქტივაცია და ამ მაღალი ტემპერატურის პროცესებისთვის საჭირო მყარი ნიღბის პროცესი.
კრისტალების ნელი ზრდა: Si კრისტალური ღეროს ზრდის ტემპმა შეიძლება მიაღწიოს 30-150 მმ/სთ-ს, ხოლო 1-3 მეტრიანი სილიციუმის კრისტალური ღეროს წარმოებას მხოლოდ დაახლოებით 1 დღე სჭირდება; მაგალითად, PVT მეთოდით SiC კრისტალური ღეროს ზრდის ტემპი დაახლოებით 0.2-0.4 მმ/სთ-ია, 3-6 სმ-ზე ნაკლების გასაზრდელად 7 დღეა საჭირო, ზრდის ტემპი სილიციუმის მასალის 1%-ზე ნაკლებია, წარმოების მოცულობა კი უკიდურესად შეზღუდულია.
მაღალი პროდუქტის პარამეტრები და დაბალი მოსავლიანობა: SiC სუბსტრატის ძირითადი პარამეტრებია მიკრომილაკების სიმკვრივე, დისლოკაციის სიმკვრივე, წინაღობა, დეფორმაცია, ზედაპირის უხეშობა და ა.შ. ეს არის რთული სისტემური ინჟინერია, რათა ატომები განლაგდეს დახურულ მაღალტემპერატურულ კამერაში და დასრულდეს კრისტალის ზრდა, პარამეტრების ინდექსების კონტროლის პარალელურად.
მასალას ახასიათებს მაღალი სიმტკიცე, მაღალი სიმყიფე, ხანგრძლივი ჭრის დრო და მაღალი ცვეთა: SiC-ის მოჰსის სიმტკიცე 9.25 ბრილიანტის შემდეგ მეორეა, რაც მნიშვნელოვნად ზრდის ჭრის, დაფქვისა და გაპრიალების სირთულეს და 3 სმ სისქის ზოდის 35-40 ნაწილის დაჭრას დაახლოებით 120 საათი სჭირდება. გარდა ამისა, SiC-ის მაღალი სიმყიფის გამო, ვაფლის დამუშავებისას ცვეთა უფრო მეტი იქნება და გამომავალი კოეფიციენტი მხოლოდ დაახლოებით 60%-ია.
განვითარების ტენდენცია: ზომის ზრდა + ფასის შემცირება
გლობალური SiC ბაზრის 6 დიუმიანი წარმოების ხაზი მწიფდება და წამყვანი კომპანიები 8 დიუმიან ბაზარზე შემოვიდნენ. შიდა განვითარების პროექტები ძირითადად 6 დიუმიან ხაზებზეა. ამჟამად, მიუხედავად იმისა, რომ ადგილობრივი კომპანიების უმეტესობა კვლავ 4 დიუმიან წარმოების ხაზებზეა დაფუძნებული, ინდუსტრია თანდათან ფართოვდება 6 დიუმიან ხაზებამდე, 6 დიუმიანი დამხმარე აღჭურვილობის ტექნოლოგიის განვითარებასთან ერთად, შიდა SiC სუბსტრატის ტექნოლოგიაც თანდათან აუმჯობესებს დიდი ზომის წარმოების ხაზების მასშტაბის ეკონომიას და ამჟამინდელი შიდა 6 დიუმიანი მასობრივი წარმოების დროის სხვაობა 7 წლამდე შემცირდა. ვაფლის უფრო დიდმა ზომამ შეიძლება გამოიწვიოს ცალკეული ჩიპების რაოდენობის ზრდა, მოსავლიანობის გაუმჯობესება და კიდის ჩიპების პროპორციის შემცირება, ხოლო კვლევისა და განვითარების ღირებულება და მოსავლიანობის დანაკარგი შენარჩუნდება დაახლოებით 7%-ის დონეზე, რითაც გაუმჯობესდება ვაფლის გამოყენება.
მოწყობილობის დიზაინში ჯერ კიდევ ბევრი სირთულეა
SiC დიოდის კომერციალიზაცია თანდათან იხვეწება, ამჟამად, რიგმა ადგილობრივმა მწარმოებელმა შექმნა SiC SBD პროდუქტები, საშუალო და მაღალი ძაბვის SiC SBD პროდუქტებს აქვთ კარგი სტაბილურობა, სატრანსპორტო საშუალებების OBC-ში, SiC SBD+SI IGBT-ის გამოყენება სტაბილური დენის სიმკვრივის მისაღწევად. ამჟამად, ჩინეთში SiC SBD პროდუქტების პატენტის დიზაინში არანაირი ბარიერი არ არსებობს და უცხო ქვეყნებთან არსებული სხვაობა მცირეა.
SiC MOS-ს ჯერ კიდევ ბევრი სირთულე აქვს, SiC MOS-სა და უცხოელ მწარმოებლებს შორის ჯერ კიდევ არსებობს უფსკრული და შესაბამისი წარმოების პლატფორმა ჯერ კიდევ მშენებლობის პროცესშია. ამჟამად, ST, Infineon, Rohm და სხვა 600-1700V SiC MOS-ებმა მიაღწიეს მასობრივ წარმოებას და ხელი მოაწერეს და გაიგზავნნენ მრავალ საწარმოო ინდუსტრიასთან, მაშინ როდესაც ამჟამინდელი ადგილობრივი SiC MOS დიზაინი ძირითადად დასრულებულია, მრავალი დიზაინის მწარმოებელი მუშაობს ქარხნებთან ვაფლის ნაკადის ეტაპზე და შემდგომი მომხმარებლის დადასტურებას ჯერ კიდევ გარკვეული დრო სჭირდება, ამიტომ ფართომასშტაბიანი კომერციალიზაციამდე ჯერ კიდევ დიდი დროა დარჩენილი.
ამჟამად, ბრტყელი სტრუქტურა ძირითადი არჩევანია და მომავალში თხრილის ტიპი ფართოდ გამოიყენება მაღალი წნევის ველში. ბრტყელი სტრუქტურის SiC MOS მწარმოებლების დიდი რაოდენობა არსებობს, ბრტყელი სტრუქტურის ლოკალური ავარიის პრობლემების წარმოქმნა ღართან შედარებით ადვილი არ არის, რაც გავლენას ახდენს მუშაობის სტაბილურობაზე. 1200 ვოლტზე დაბალ ბაზარზე გამოყენების ფართო სპექტრი აქვს და ბრტყელი სტრუქტურა წარმოების თვალსაზრისით შედარებით მარტივია, რაც აკმაყოფილებს წარმოებისა და ხარჯების კონტროლის ორ ასპექტს. ღარიან მოწყობილობას აქვს უკიდურესად დაბალი პარაზიტული ინდუქციურობა, სწრაფი გადართვის სიჩქარე, დაბალი დანაკარგები და შედარებით მაღალი შესრულება.
2--SiC ვაფლის სიახლეები
სილიკონის კარბიდის ბაზრის წარმოება და გაყიდვების ზრდა, ყურადღება მიაქციეთ მიწოდებასა და მოთხოვნას შორის სტრუქტურულ დისბალანსს


მაღალი სიხშირის და მაღალი სიმძლავრის დენის ელექტრონიკის ბაზრის მოთხოვნის სწრაფ ზრდასთან ერთად, სილიკონზე დაფუძნებული ნახევარგამტარული მოწყობილობების ფიზიკური შეზღუდვა თანდათან გახდა თვალსაჩინო და მესამე თაობის ნახევარგამტარული მასალები, რომლებიც წარმოდგენილია სილიციუმის კარბიდით (SiC), თანდათან გახდა ინდუსტრიალიზებული. მასალის მახასიათებლების თვალსაზრისით, სილიციუმის კარბიდს აქვს სილიციუმის მასალასთან შედარებით 3-ჯერ დიდი ზოლის სიგანე, 10-ჯერ დიდი კრიტიკული ელექტრული ველის სიძლიერე და 3-ჯერ მეტი თბოგამტარობა, ამიტომ სილიციუმის კარბიდის დენის მოწყობილობები შესაფერისია მაღალი სიხშირის, მაღალი წნევის, მაღალი ტემპერატურის და სხვა გამოყენებისთვის, ხელს უწყობს დენის ელექტრონული სისტემების ეფექტურობისა და სიმძლავრის სიმკვრივის გაუმჯობესებას.
ამჟამად, SiC დიოდები და SiC MOSFET-ები თანდათანობით გამოჩნდა ბაზარზე და გამოჩნდა უფრო მოძველებული პროდუქტები, რომელთა შორის ზოგიერთ სფეროში ფართოდ გამოიყენება SiC დიოდები სილიციუმის დიოდების ნაცვლად, რადგან მათ არ აქვთ უკუ აღდგენის მუხტის უპირატესობა; SiC MOSFET ასევე თანდათანობით გამოიყენება საავტომობილო ინდუსტრიაში, ენერგიის შენახვაში, დამუხტვის სისტემებში, ფოტოელექტრულ და სხვა სფეროებში; საავტომობილო გამოყენების სფეროში მოდულარიზაციის ტენდენცია სულ უფრო თვალსაჩინო ხდება, SiC-ის უმაღლესი შესრულება უნდა დაეყრდნოს მოწინავე შეფუთვის პროცესებს, ტექნიკურად შედარებით მოწიფული გარსის დალუქვით, როგორც მეინსტრიმი, მომავალში ან პლასტმასის დალუქვის განვითარებისთვის, მისი მორგებული განვითარების მახასიათებლები უფრო შესაფერისია SiC მოდულებისთვის.
სილიკონის კარბიდის ფასის ვარდნის სიჩქარე ან წარმოუდგენლად მაღალი

სილიციუმის კარბიდის მოწყობილობების გამოყენება ძირითადად შეზღუდულია მაღალი ფასით, SiC MOSFET-ის ფასი იმავე დონეზე 4-ჯერ მეტია Si-ზე დაფუძნებული IGBT-ის ფასის ტოლფასია, ეს იმიტომ ხდება, რომ სილიციუმის კარბიდის პროცესი რთულია, რომელშიც მონოკრისტალის და ეპიტაქსიის ზრდა არა მხოლოდ გარემოსთვის საზიანოა, არამედ ზრდის ტემპიც ნელია და მონოკრისტალის სუბსტრატად დამუშავება ჭრისა და გაპრიალების პროცესს უნდა გაიაროს. საკუთარი მასალის მახასიათებლებისა და დამუშავების ტექნოლოგიის გამო, ადგილობრივი სუბსტრატის მოსავლიანობა 50%-ზე ნაკლებია და სხვადასხვა ფაქტორი იწვევს სუბსტრატის და ეპიტაქსიის მაღალ ფასებს.
თუმცა, სილიციუმის კარბიდის მოწყობილობებისა და სილიციუმის ბაზაზე დაფუძნებული მოწყობილობების ღირებულების შემადგენლობა დიამეტრალურად საპირისპიროა, წინა არხის სუბსტრატისა და ეპიტაქსიური ხარჯები მთლიანი მოწყობილობის 47%-ს და 23%-ს შეადგენს, შესაბამისად, დაახლოებით 70%-ს, უკანა არხის მოწყობილობის დიზაინის, წარმოებისა და დალუქვის რგოლები მხოლოდ 30%-ს შეადგენს, სილიციუმის ბაზაზე დაფუძნებული მოწყობილობების წარმოების ღირებულება ძირითადად უკანა არხის ვაფლის წარმოებაზეა კონცენტრირებული დაახლოებით 50%-ით, ხოლო სუბსტრატის ღირებულება მხოლოდ 7%-ს შეადგენს. სილიციუმის კარბიდის ინდუსტრიული ჯაჭვის ღირებულების თავდაყირა შეცვლის ფენომენი ნიშნავს, რომ ზედა დინების სუბსტრატის ეპიტაქსიური მწარმოებლებს აქვთ ძირითადი უფლება ისაუბრონ, რაც ადგილობრივი და უცხოური საწარმოების განლაგების გასაღებია.
ბაზარზე დინამიური თვალსაზრისით, სილიციუმის კარბიდის ღირებულების შემცირება, სილიციუმის კარბიდის გრძელი კრისტალებისა და დაჭრის პროცესის გაუმჯობესებასთან ერთად, ვაფლის ზომის გაფართოებასაც გულისხმობს, რაც წარსულში ნახევარგამტარული განვითარების მომწიფებული გზა იყო. Wolfspeed-ის მონაცემები აჩვენებს, რომ სილიციუმის კარბიდის სუბსტრატის 6 ინჩიდან 8 ინჩამდე განახლების შემთხვევაში, კვალიფიციური ჩიპების წარმოება შეიძლება გაიზარდოს 80%-90%-ით და ხელი შეუწყოს მოსავლიანობის გაუმჯობესებას. შეუძლია შეამციროს ერთეულის კომბინირებული ღირებულება 50%-ით.
2023 წელი ცნობილია, როგორც „8 დიუმიანი SiC-ის პირველი წელი“, წელს, როგორც ადგილობრივი, ასევე უცხოური სილიციუმის კარბიდის მწარმოებლები აჩქარებენ 8 დიუმიანი სილიციუმის კარბიდის განლაგებას, მაგალითად, Wolfspeed-მა 14.55 მილიარდი აშშ დოლარის ინვესტიცია ჩადო სილიციუმის კარბიდის წარმოების გაფართოებისთვის, რომლის მნიშვნელოვანი ნაწილია 8 დიუმიანი SiC სუბსტრატის მწარმოებელი ქარხნის მშენებლობა. იმისათვის, რომ უზრუნველყოფილი იყოს 200 მმ SiC შიშველი ლითონის მიწოდება რიგი კომპანიებისთვის, Domestic Tianyue Advanced-მა და Tianke Heda-მ ასევე გააფორმეს გრძელვადიანი ხელშეკრულებები Infineon-თან, რათა მომავალში მიაწოდონ 8 დიუმიანი სილიციუმის კარბიდის სუბსტრატები.
„Wolfspeed“-ი ვარაუდობს, რომ წელს სილიციუმის კარბიდის ფასი 6 ინჩიდან 8 ინჩამდე გაიზრდება. „Wolfspeed“-ი ვარაუდობს, რომ 2024 წლისთვის 8 ინჩიანი სუბსტრატის ჩიპის ღირებულება 2022 წლის 6 ინჩიანი სუბსტრატის ჩიპის ღირებულებასთან შედარებით 60%-ზე მეტით შემცირდება და ფასების შემცირება კიდევ უფრო გახსნის აპლიკაციების ბაზარს, აღნიშნულია „Ji Bond Consulting“-ის კვლევის მონაცემებში. 8 ინჩიანი პროდუქტების ამჟამინდელი საბაზრო წილი 2%-ზე ნაკლებია და მოსალოდნელია, რომ 2026 წლისთვის ის დაახლოებით 15%-მდე გაიზრდება.
სინამდვილეში, სილიციუმის კარბიდის სუბსტრატის ფასის კლების ტემპი შეიძლება ბევრის წარმოსახვას აღემატებოდეს, 6 დიუმიანი სუბსტრატის ამჟამინდელი ბაზარზე შეთავაზება 4000-5000 იუანია/ცალი, წლის დასაწყისთან შედარებით მნიშვნელოვნად დაეცა, მოსალოდნელია, რომ მომავალ წელს 4000 იუანზე დაბლა დაეცეს. აღსანიშნავია, რომ ზოგიერთმა მწარმოებელმა პირველი ბაზრის მოსაპოვებლად გაყიდვების ფასი ქვემოთ მოცემულ ზღვრამდე შეამცირა. ფასების ომის მოდელი გაიხსნა, ძირითადად კონცენტრირებული იყო სილიციუმის კარბიდის სუბსტრატის მიწოდებაზე, რომელიც შედარებით საკმარისი იყო დაბალი ძაბვის სფეროში, ადგილობრივი და უცხოელი მწარმოებლები აგრესიულად აფართოებენ წარმოების შესაძლებლობებს, ან უშვებენ სილიციუმის კარბიდის სუბსტრატის ჭარბი მიწოდების ეტაპს წარმოდგენილზე ადრე.
გამოქვეყნების დრო: 2024 წლის 19 იანვარი
